书籍:《炬丰科技-半导体工艺》
文章:微细加工中的湿法化学处理原理
编号:JFKJ-21-754
作者:炬丰科技
硅技术中湿式化学加工的基本原理
优势反应(蚀刻)种
—从图中可以看出。Si02的蚀刻速率随着高频浓度的增加而增加,但它几乎与等效摩尔比线以上的NH4F浓度无关。另一方面,已经发现,Si02薄膜不是用NH4F溶液蚀刻,这是一种强电解质,即溶液中存在大量的f离子。这两个结果似乎表明,SiOz的优势蚀刻物种是HF;,而不是F-离子。NH4F溶液的电导率如图所示。 我们用铂制成的平行电极测量了电导率。单元格常数为1.025,并在3000Hz下进行。随着NH4F浓度的增加,电导率增加,在浓度为7aol/l时达到最大值,然后降低。在-300I-8 200 >Ecv2中,离子的有效离子浓度比值随着NH、F的增加而减小。
化学成分的稳定性
----传统的BHF在运输和储存过程中,尤其是NH、HF的固相分离,特别是在冬季。在高频浓度为6-8%的常规BHF中,固相分离发生在9-17“c的倾斜温度处。测量了固相分离温度与NH4F浓度之间的关系,如图所示。 11.冻结凹陷曲线和溶解度曲线两种关系有一个交点。这代表了最小的固相分离温度。
刨花层表面的可湿性
—提高液体化学物质的润湿特性,以实现晶片表面的完全清洁,这一点至关重要。然而,在**的硅表面上,BHF具有较大的表面张力值,从84dyne/cm到93dyne/cm,高接触角从69度到73度。为了提高BHF在晶片表面的润湿性,有必要添加选定的烃类表面活性剂,如脂肪族胺、酸和醇。其中表明表面活性剂基本上需要以下10种特性:1)与BHF相同的蚀刻速率;2)低接触角;3)不分离;4)无发泡;5)低颗粒;6)低杂质(净化可能性);7)晶片表面低颗粒粘附;8)无表面残留;9)表面光滑性优异;10)的蚀刻选择性高。
此外,先进的BHF延长了浴的寿命,因为它易于再循环过滤,其寿命受到蚀刻产物水平而不是颗粒浓度水平的限制。传统BHF的寿命由粒子污染的密度决定的。由于传统BHF的润湿性较差,再循环过滤效果不佳。
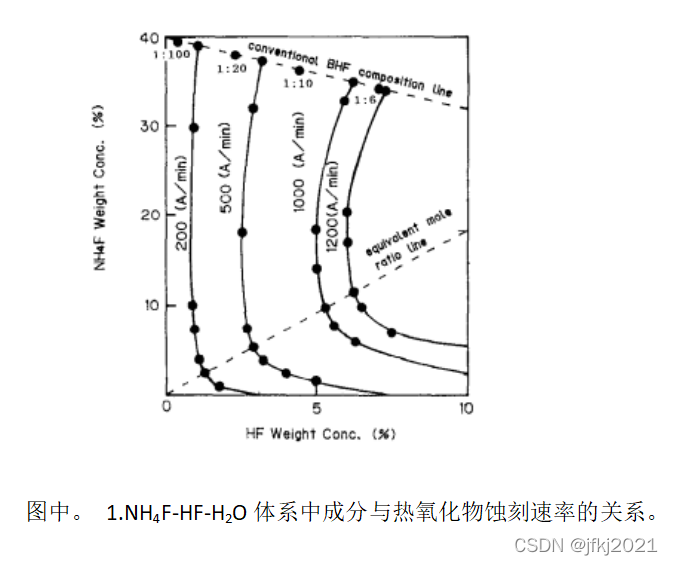
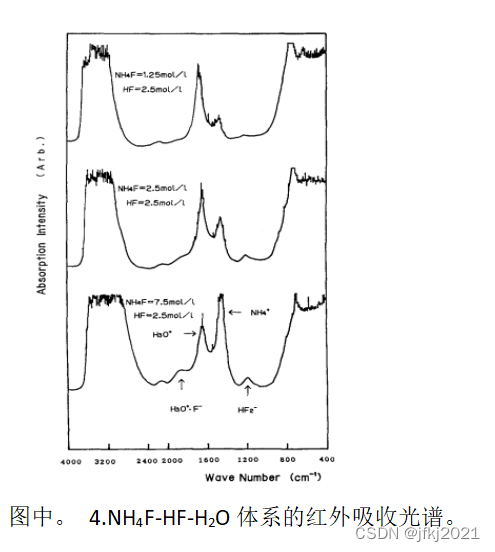
总结
基于液体化学物质的电离机制和表面化学反应,从理论的角度研究了BHF的化学成分的改进。对BHF的解离机理进行了理论和实验研究,结论是HF2是Si02蚀刻过程中主要的活性离子种类。测定了氧化硅薄膜的蚀刻速率与H+离子浓度的关系。NH4F-HF-H2O体系中SiO、薄膜的刻蚀刻速率随HF;离子浓度呈线性增加,而随着H+离子浓度的降低呈对数下降,即使HF;离子浓度保持不变。我们的结论是蚀刻溶液的液体化学成分必须选择具有最合适的高频浓度和离子种类。
液体化学物质的组成和性质应考虑以下特性:蚀刻产物在蚀刻溶液中的充分溶解度、固相的充分分离温度和优异的润湿性。1)具有NH4F浓度过量的BHF的普通成分会导致一些严重的问题,过量的NH4F不会导致与氧化硅的离子反应,由于BHF中缺乏蚀刻产物的溶解性,严重降低了蚀刻的均匀性和线性。2)我们发现,SiO蚀刻产物的溶解度在BHF中随着NH4F浓度的降低而增加。3)另一个实际障碍是NH4HF2低温环境下晶体的固相分离。这种固相分离产生粒子,并导致液体化学成分的成分变化。考虑到液体化学品的运输和储存,特别是在冬季,固相分离温度必须尽可能低。改进的BHF组成,NH4F浓度约为15%,被限制以解决这些问题,并以完全线性和均匀性进行蚀刻。4)通过适当添加表面活性剂,液体化学物质在晶片表面表现出良好的润湿性,并允许进行高质量的湿式化学加工。在SiO后,晶片表面完全平滑,通过引入NH4F浓度为15%的先进表面活性BHF和选定的碳氢化合物表面活性剂,如脂肪族胺和脂肪族醇来实现蚀刻。


版权声明:本文内容由互联网用户自发贡献,该文观点仅代表作者本人。本站仅提供信息存储空间服务,不拥有所有权,不承担相关法律责任。如发现本站有涉嫌侵权/违法违规的内容,请联系我们,一经查实,本站将立刻删除。
如需转载请保留出处:https://51itzy.com/kjqy/22503.html